Reaction Ion Etching
Reactive ion etching is a technique for removing material from a sample. This is achieved by ionizing a reactive gas and directing it towards the sample surface. A chemical reaction between the reactive gas and the sample material produces a byproduct that evaporates away. This technique can etch very specific materials depending on the reactive gases available.
Oxford Instrument Plasmalab System 100 ICP
| Description | Specification |
|---|---|
| Sample | 100 [mm] Wafer or Custom size |
| Gases | Ar, O2, CHF3, SF6, C4F8, H2 |
| RF Power | 0 to 300 [W] |
| ICP Power | 0 to 1500 [W] |
| Temperature | -150 [°C] to 50 [°C] |
| Helium Backside Cooling | Yes |
| Bosch Process | Yes |
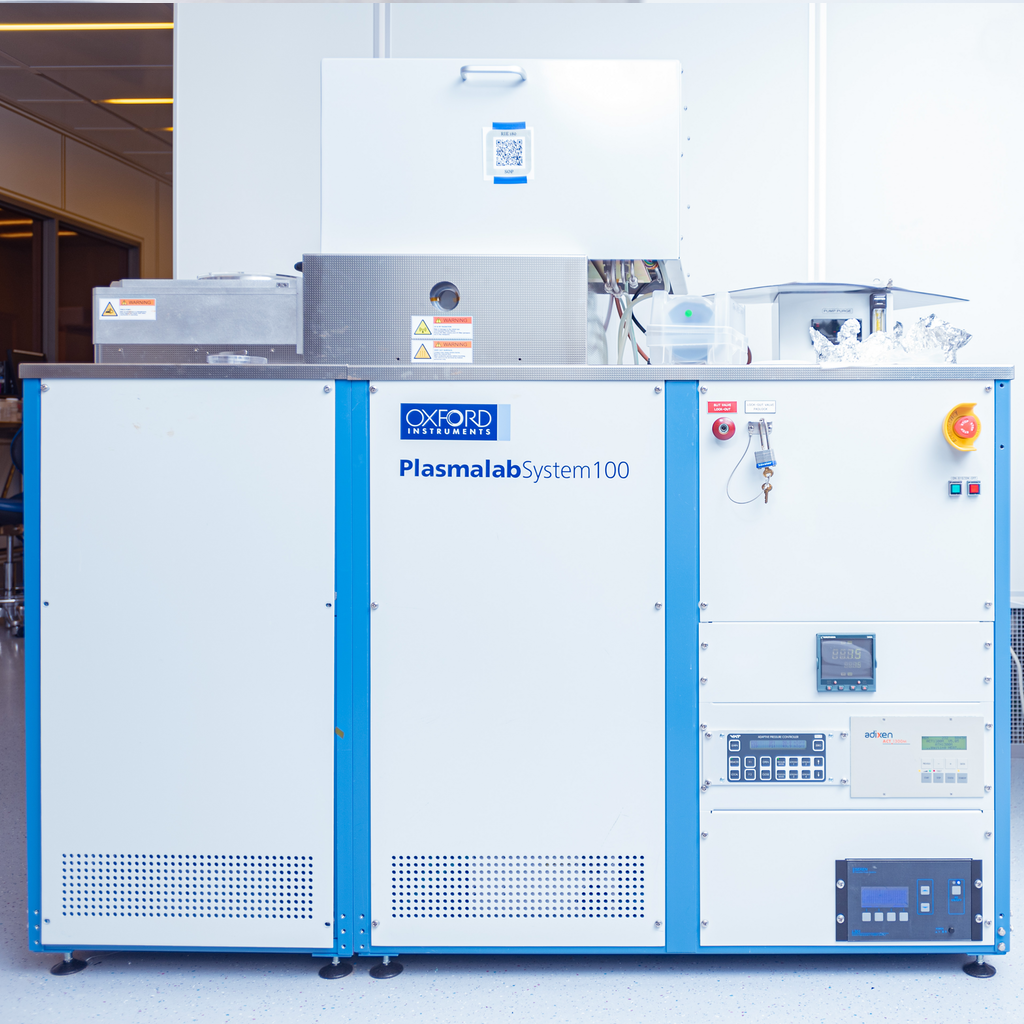
Core Technology
| Core Technology | Description |
|---|---|
| SOP: RIE180 | This document is the standard operating procedure (SOP) for the Oxford Instrument Plasmalab System 100 ICP (RIE180) at UHNF. This SOP serves as a foundation for initial training and ensures that the equipment can be operated correctly, by everyone, the first time. |
| SSP: RIE180 | This is a service manual we developed for the Oxford Instrument Plasmalab System 100 ICP (RIE180) at UHNF. This document ensures that any staff can effectively perform routine service or repairs effectively, quickly and at significantly lower cost. This document is restricted to equipment custodians. Contact us for access. |
| Processes | The Process Viewer is a searchable datable of all processes at UHNF. This database is used to often complete new projects during the first run. |